| 新能源 新的BONDSCALE™ 系统大大提升了晶圆键合的生产率;解决了IRDS路线图中描述的晶体管逻辑电路扩展和3D集成的问题。 奥地利,圣弗洛里安,2019年3月12日——面向MEMS、纳米技术和半导体市场的晶圆键合与光刻设备的领先供应商EV集团 (EVG) 今日推出了全新的BONDSCALE™自动化生产熔融系统。BONDSCALE旨在满足各种熔融/分子晶圆键合应用,包括工程基板制造和使用材料层转移进行3D集成的方法,如单片3D (M3D)。通过BONDSCALE,EV集团将晶圆键合引入前端半导体处理,并协助解决国际半导体技术发展路线图 (IRDS)中提出的扩展 “深度摩尔” 逻辑器件的长期问题。与现有的熔融平台相比,BONDSCALE采用了增强的边缘对准技术,大大提高了晶圆键合生产率并降低了成本 (CoO),目前该解决方案已向客户供货。 EVG将在SEMICON China上展示最新的晶圆键合解决方案,包括BONDSCALE。SEMICON China是中国首要的半导体行业展会,本届展会将于3月20日-22日在上海新国际展览中心举办。与会者如有兴趣了解更多EVG的信息,可前往N2厅的2547号EVG展位。 BONDSCALE与EV集团的行业基准GEMINI®FB XT自动熔融系统一起销售,每个系统平台都针对不同的应用。BONDSCALE主要用于工程基板键合和层转移处理,而GEMINI FB XT将支持需要更高对准精度的应用,例如存储器堆叠、3D 片上系统 (SoC)、背照式 CMOS 图像传感器堆叠以及芯片分区。
直接晶圆键合是提升半导体缩放性能的关键 根据IRDS路线图,在未来几年里,寄生缩放将成为逻辑器件性能拓展的主要驱动因素,需要新的晶体管结构和材料。 IRDS路线图还指出,新的3D集成方法 (如M3D) 将成为支持从2D到3D VLSI长期过渡的重要手段,包括后台电源分配、N&P叠加、内存逻辑、集群功能栈和beyond-CMOS集成。层传输过程和工程基板通过提升器件性能和降低功耗,从而实现逻辑扩展技术。采用等离子激活的直接晶圆键合是一种可靠的解决方案,可实现不同材料、高质量工程基板以及薄硅层转移应用的多样化集成。 “作为晶圆键合领域的先驱和市场领导者,EV集团一直在帮助客户将新半导体技术从早期研发转向制造的最前沿,”EV集团技术执行总监Paul Lindner表示。“大约25年前,EV集团推出业界首款绝缘体硅片(SOI)晶圆键合机,以支持生产细分应用产品的高频和抗辐射设备。 从那时起,我们不断提高我们的直接键合平台的性能和CoO,来帮助我们的客户将工程基板的优势带到更广泛的应用中。我们新的BONDSCALE解决方案将其提升到了一个新的水平,提高了生产力,满足了对工程基板和层转移处理不断增长的需求,从而在‘深度摩尔’时代实现下一代逻辑和存储器件持续的高性能、低功耗和面积扩展。” EV集团推出BONDSCALE熔融晶圆键合平台 BONDSCALE是用于前端应用所需的熔融/直接晶圆键合的大批量生产系统。BONDSCALE系统采用EV集团的LowTemp™等离子激活技术,将熔融键合的所有重要步骤 —— 包括清洗、等离子激活、对准、预键合和红外检测 —— 结合在一个适用于各种熔融/分子晶圆键合应用的单一平台中。该系统能够处理200毫米和300毫米晶圆,确保无空隙、高产量和高产量的生产过程。 BONDSCALE采用新一代熔融/直接键合模块,一种新型晶圆处理系统和光学边缘对准系统,可提高产量和生产率,以满足客户对工程基板晶圆生产和M3D集成增产的需求。 关于 EV 集团(EVG) EV集团(EVG)是为半导体、微机电系统(MEMS)、化合物半导体、功率器件和纳米技术器件制造提供设备与工艺解决方案的领先供应商。其主要产品包括:晶圆键合、薄晶圆处理、光刻/纳米压印光刻(NIL)与计量设备,以及涂胶机、清洗机和检测系统。EV集团成立于1980年,可为遍及全球的众多客户和合作伙伴网络提供各类服务与支持。 |
EV集团推出用于扩展“深度摩尔”和前端处理的新一代熔融晶圆键合技术
文章来源:中国能源网 发布时间:2019-03-12
摘要:中国能源网新闻栏目涵盖能源经济、煤炭、电力、石油天然气、新兴能源、节能环保、分布式能源等方面的国际及国内能源新闻资讯,供您了解能源行业市场动态、项目建设、行业监管、分析综述、国内国际能源新闻资讯。
下一篇:重庆最大光伏发电项目将于5月建成
美国提出完善太阳能法规,实现气候目标
2019-03-12
我国太阳能发电行业发展现状及建议2019-03-12
福莱特:拟60亿元投建光伏组件玻璃项目2019-03-12
中国光伏组件出口分析2019-03-12
全国人大代表、通威集团董事局主席刘汉元:连续10年为光伏产业健康发展鼓与呼2019-03-12
两大千亿巨头首 “闯” 光伏一体化,谁是下一个隆基?2019-03-12
政策汇总:20个省市光伏配储能要求(建议收藏)2019-03-12
央视披露光伏人才荒:企业“加价”抢人,年薪50万元招人难!2019-03-12
PV InfoLink权威报告:2022年大尺寸组件市占率近8成,超高功率组件引领分布式行业新纪元2019-03-12
其他资讯
- 全国政协十三届五次会议首场新闻发布会
全国政协十三届五次会议新闻发布会今天(3月3日)下午举行,新闻发布会采用网络视频... - 我国对欧投资保持逆势增长 2021年中欧...
商务部有关负责人表示,2021年,尽管面临的形势比较复杂严峻,但是中欧之间的经贸... - 中国两会的世界期待
2022年全国两会召开在即。在新冠疫情持续不断、全球经济复苏充满不确定性、国际格... - ·十三届全国人大常委会第三十三次会议在京举行
- ·国家发改委:坚决淘汰煤化工领域落后产能
- ·两部门:健全能源供应保障和储备应急体系
- ·全球天然气价格暴涨,中国如何打赢今冬“冷战”...
- ·全球制造业PMI连续下降 全球经济复苏动能持...
- ·习近平出席2022世界经济论坛视频会议并发表...
- ·国家能源局关于印发能源领域深化“放管服”改革...
- ·国家能源局 农业农村部 国家乡村振兴局关于印...

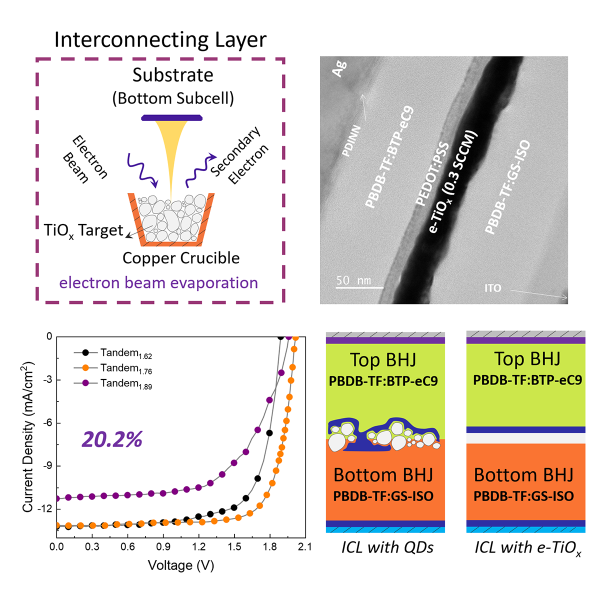

 吉公网安备 22010402000830号
吉公网安备 22010402000830号